今天潜在发酵方向也是华海诚科的主营业务环氧塑封料。相关词条600多个,正宗的基本都在下面,周五给大家推荐最正宗的小盘10cm股票,周末可能发酵,周一大概率一字的票他就是宏昌电子!



下面先简单介绍下宏昌电子和环氧塑封料
宏昌电子主要从事电子级环氧树脂、覆铜板两大类产品的生产和销售。公司的主要产品有阻燃环氧树脂、液态环氧树脂、固态环氧树脂、溶剂环氧树脂、其他环氧树脂。公司在环氧树脂行业,是最早进入中国境内的外资企业之一。
环氧塑封料(简称 EMC)全称为环氧树脂模塑料,是用于半导体封装的一种热固性化学材料,是由环氧树脂为基体树脂,以高性能酚醛树脂为固化剂,加入硅微粉等填料,以及添加多种助剂加工而成,主要功能为保护半导体芯片不受外界环境(水汽、温度、污染等)的影响,并实现导热、绝缘、耐湿、耐压、支撑等复合功能。

问:尊敬的董秘你好!请问我公司产品可以用于先进封装以及集成电路载板么?谢谢!(来自: 上证E互动)
宏昌电子:尊敬的投资者您好! 公司与晶化科技股份有限公司达成合作,开发“先进封装增层膜新材料”,该增层膜新材料应用于半导体 FCBGA(倒装芯片球栅格阵列)等先进封装制程使用之载板中。主要合作内容: ①现有产品国产化认证推广:晶化公司已具有八年集成电路先进封装材料布局钻研,其封装增层膜产品已有厂商验证通过,技术在行业内较成熟领先,双方将合作通过公司平台,国产化向下游客户认证推广“增层膜新材料”。 ②下世代产品开发:基于公司在高频高速树脂及板材方面技术积累,双方将合作开展下世代“增层膜新材料”,技术内容以低介电损耗(Low Df)树脂体系为基础,开发高端增层膜,应用于FCBGA, FCCSP(倒装芯片级封装)等先进封装制程。 具体内容请见2023年6月27日公司于上交所网站“关于子公司珠海宏昌签订《合作框架协议书》及《技术开发(委托)合同》”等公告。谢谢关注!

宏昌电子:尊敬的投资者您好!公司覆铜板相关产品满足下游高频高速需求,公司开发的GA-886,GA-886N,GA-686等高频高速材料,并进入Intel英特尔高频高速选材参考平台。谢谢关注!
宏昌电子今天晚上回复的问题很多老师可能不太懂专业术语,这里面说的每一个英文名词都是打破国外垄断的产品
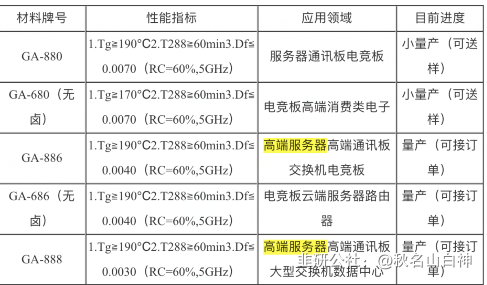
【中信化工】存储需求放量,先进封装成长可期
————————————
近期海外大厂持续加单HBM,叠加国内存储安全强化以及AI推动HBM需求持续提升,先进封装板块表现值得持续关注。
塑封料:主要包括颗粒状环氧塑封料GMC以及球硅&球铝等,建议关注华海诚科、宏昌电子及联瑞新材
底填(FC):底填材料,国产化替代持续推进中,建议关注:德邦科技、华海诚科及宏昌电子

AI的“心脏”!极度稀缺的“FC-BGA基板”
FC-BGA基板是AI的刚需载板,也是AI的“心脏”!FC-BGA具有线宽线距小、引脚多的优点,被应用于CPU、GPU、FPGA、ASIC等高性能运算,受益于云计算、AI新应用领域的蓬勃发展,Prismark预测:FC-BGA将成为IC载板行业规模最大、增速最快的细分领域。
苹果公司一直在使用FCBGA封装技术,并不断改进和提高其性能,直至最近推出的PC处理器M系列。近日苹果供应商LG Innotek开始进军FCBGA基板市场,业界推测或将为苹果M系列芯片提供FCBGA基板,这也从侧面反映出FCBGA的市场需求。苹果所用的这项封装技术,正迎来蓬勃发展。
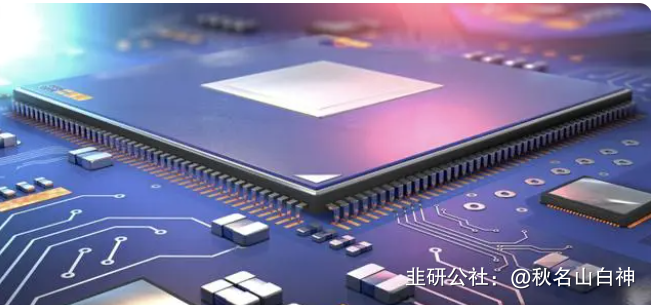
更高的密度:因为FCBGA封装技术可以在同样的封装面积内安装更多的芯片引脚,从而实现更高的集成度和更小的封装尺寸。
更好的散热性能:FCBGA能允许芯片直接连接到散热器或散热片上,从而提高了热量传递的效率。
更高的可靠性和电性能:因为它可以减少芯片与基板之间的电阻和电容等因素,从而提高信号传输的稳定性和可靠性,也可以提高信号传输的速度和准确性。
下面是 FCCSP(倒装芯片级封装)

宏昌电子进军先进封装 半导体业务成战略重点
6月26日,宏昌电子发布公告称,公司全资子公司珠海宏昌与晶化科技股份达成合作,委托开发在先进封装过程中集成电路载板之增层膜新材料等,标志着宏昌电子正式进军半导体先进封装领域。
先进封装引领“后摩尔”时代半导体发展
“先进封装”受到业界的重视,主要来自于“后摩尔”时代集成电路的微缩已接近极限。
众所周知,摩尔定律指的是随着技术演进, 芯片上容纳的晶体管数量会呈指数级增长每1.5-2年翻一倍,同时带来芯片性能提升一倍或成本下降一半的效应。通俗的理解,集成电路制造技术就是将大量的晶体管微缩集成的工艺手段,晶体管能够做的越小,性能提升越强,成本越低。
近年来,随着芯片制程已发展至3nm,单位数量晶体管的成本下降幅度正在持续降低,根据IBS的统计及预测,从16nm到10nm,每10亿颗晶体管的成本降低了30.7%,从7nm到5nm成本下降了17.8%,而从5nm到3nm成本仅下降了4.2%。同时,由于1nm的宽度中仅能容纳2个硅原子晶格,芯片工艺尺寸在物理尺度上也已接近极致。基于以上现实,业界近年来一直在探索半导体产业新的突破迭代方向,“先进封装”技术作为可行的重要技术方向,也进入了产业界的视野。
先进封装主要指的是区别于传统封装的前沿封装技术,包括倒装芯片封装、晶圆级封装、系统级封装和2.5D、3D封装等封装技术。相较于传统封装,先进封装具有引脚数量增加、芯片系统更小型化且系统集成度更高等特点,通过将处理、模拟等多种芯片集成在一个系统内,有效提升系统性能。
“先进封装”技术对我国还有额外的战略意义。自美国围绕先进制程对华为等国内企业实施制裁以后,相关企业的消费电子业务与通信业务受到了显著的影响,以“先进封装”技术为基础的chiplet路线成为华为等企业规避制裁、恢复业务的最重要途径之一。据业内消息称,华为等企业已将chiplet技术运用到通信与AI芯片领域,产业界对于chiplet的发展前景寄予厚望。
ABF材料主要为日系厂商垄断
先进封装技术的推进离不开先进IC载板的迭代与量产。其中,ABF载板作为IC载板的一种,因其线宽线距小、引脚多等优势适用于CPU、GPU、FPGA、ASIC 等高性能运算芯片。
然而,IC载板市场护城河极深,属于尖端技术领域,主要玩家为日韩台区域的企业。以ABF载板积层绝缘膜为例(ABF),该市场主要由日本企业味之素垄断,市场占有率超过90%以上,ABF市场的第二大企业积水化学也为日本企业。
由于ABF载板广泛运用于HPC、HBM、AI等领域,随着下游产业的高速发展,叠加先进封装技术的发展对ABF载板的需求,ABF市场的增长潜力在未来几年深受业内看好。然而,业内第一大企业味之素虽已宣布扩产计划,但未来三年其产能年复合增长率仅为14%,远远跟不上市场对于ABF产品的增长需求。
另一方面,近年来,日本和美国形成半导体产业同盟,陆续出台了对华半导体出口限制措施,加快对国内半导体产业的围堵,ABF成为迫在眉睫的卡脖子领域。
值得庆幸的是,先进封装技术所涉及的半导体后道领域,国内产业界的实力相对更具竞争力,当前对于相关短板领域的攻关,也是国内半导体产业突破封锁最有机会的路径之一。
时间表明确 宏昌电子重点布局半导体材料
此次宏昌电子选择的合作对象似有深意。晶化科技被业内公认为在ABF领域技术仅次于味之素与积水化学的第三大企业。由于早有布局钻研,其产品TBF已在多家厂商验证通过,技术在世界范围内处于较成熟水平。选择与晶化科技合作这一决策,体现出宏昌电子锚定成熟技术路线,合理控制研发不确定性,一举取得制造技术源头的战略意图。
同时,宏昌电子在公告中也明确披露了时间规划表。按照合同规定,晶化科技需在2024年5月1日-2024年6月20日之间,向宏昌电子交付介电损耗低于0.004(10GHz)的50m合格增层膜样品进行产品验证。按照此规划,如若进展顺利,宏昌电子将能顺利搭上先进封装技术与AI计算高速发展的东风,抢占ABF市场份额。
宏昌电子作为国内首家拥有打通上下游产业链的环氧树脂及覆铜板的上市企业,宏昌电子此次与晶化科技公司合作,除了引进一批熟悉半导体制程的研发团队,延续高频高速板材刚获得Intel公司最新BirchStream平台认证,展现高多层板印制电路板中材料开发实力,更进一步藉由生产及销售芯片封装用核心材料,在多年努力厚积薄发下,一举跨入半导体领域,为作好2030年6G卫星互联高频高速应用设备作铺垫。
近年来,半导体产业对于国民经济发展的支撑作用越发得到社会认知,而国内半导体产业的整体进步需要所有方面的力量支持。作为在电子材料领域深耕数十年的老牌企业,宏昌电子此次布局半导体产业,既体现出该企业对未来产业发展趋势的敏锐把握,也充分说明公司对于自身产业优势的准确认知。有理由相信,依靠公司在电子材料领域数十年的深厚研发经验,宏昌电子有望为半导体产业的国产化贡献出自己的一份力量。





- 老师,这个票业绩是不是可能要预披露?不用考虑这个?00打赏回复投诉于2023-07-15 23:21:40更新查看2条回复
- 1
- 2










